好意思国本质室研发新式激光技能,有望大幅晋升芯片制造服从

IT之家 1 月 5 日音信,好意思国劳伦斯利弗莫尔国度本质室(LLNL)正在研发一种基于铥元素的拍瓦(petawatt)级激光技能,该技能有望取代刻下极紫外光刻(EUV)器具中使用的二氧化碳激光器,并将光源服从晋升约十倍。这一结巴可能为新一代“卓绝 EUV”的光刻系统铺平谈路,从而以更快的速率和更低的能耗制造芯片。
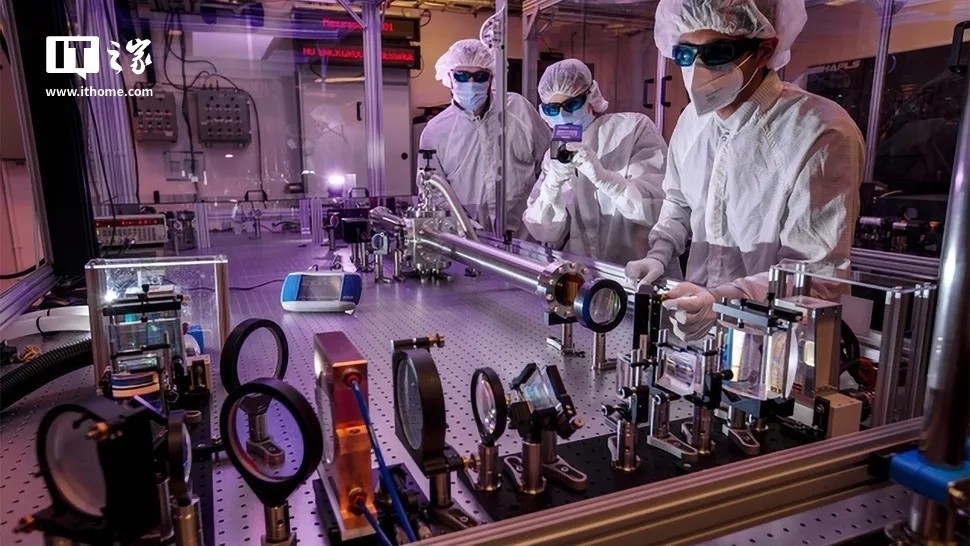
刻下,EUV 光刻系统的能耗问题备受柔软。以低数值孔径(Low-NA)和高数值孔径(High-NA)EUV 光刻系统为例,其功耗分袂高达 1,170 千瓦和 1,400 千瓦。这种高能耗主要源于 EUV 系统的责任旨趣:高能激光脉冲以每秒数万次的频率挥发锡滴(50 万摄氏度),以酿成等离子体并放射 13.5 纳米波长的光。这已经过不仅需要迢遥的激光基础技艺和冷却系统,还需要在真空环境中进行以幸免 EUV 光被空气接管。此外,EUV 器具中的先进反射镜只可反射部分 EUV 光,因此需要更苍劲的激光来提高产能。
IT之家选藏到,LLNL 主导的“大口径铥激光”(BAT)技能旨在处置上述问题。与波长约为 10 微米的二氧化碳激光器不同,BAT 激光器的责任波长为 2 微米,表面上不详提高锡滴与激光互相作用时的等离子体到 EUV 光的退换服从。此外,BAT 系统采用二极管泵浦固态技能,相较于气体二氧化碳激光器,具有更高的全体电服从和更好的热治理能力。
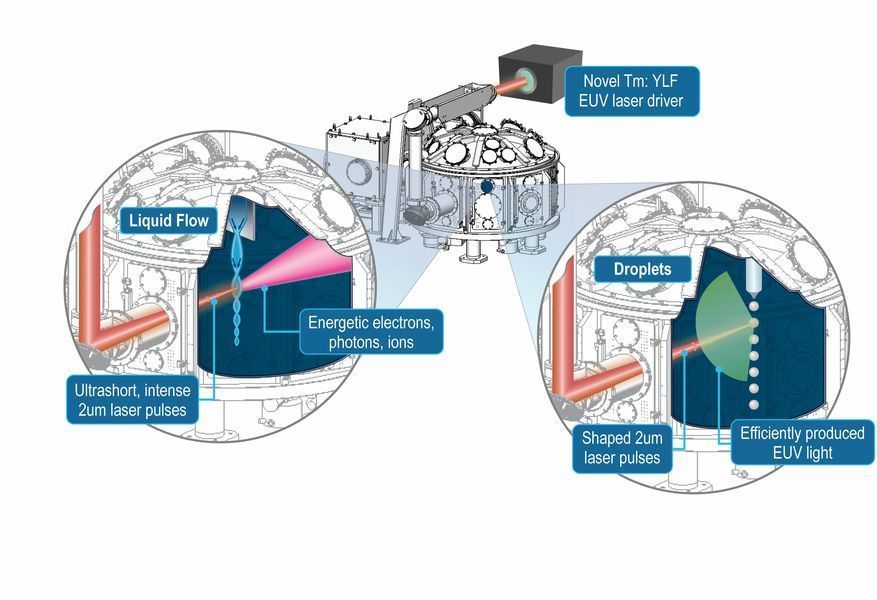
率先,LLNL 的盘考团队贪图将这种紧凑且高叠加率的 BAT 激光器与 EUV 光源系统集会,测试其在 2 微米波长下与锡滴的互相作用服从。LLNL 激光物理学家布伦丹・里根(Brendan Reagan)暗示:“夙昔五年中,咱们已经完成了表面等离子体模拟和认识考证本质,为这一相貌奠定了基础。咱们的责任已经在 EUV 光刻限制产生了病笃影响,目下咱们对下一步的盘考充满期待。”
干系词,将 BAT 技能诈欺于半导体分娩仍需克服要紧基础技艺矫正的挑战。刻下的 EUV 系统经过数十年才得以熟悉,因此 BAT 技能的骨子诈欺可能需要较万古候。
据行业分析公司 TechInsights 议论,到 2030 年,半导体制造厂的年耗电量将达到 54,000 吉瓦(GW),越过新加坡或希腊的年用电量。如若下一代超数值孔径(Hyper-NA)EUV 光刻技能插足商场,能耗问题可能进一步加重。因此,行业对更高效、更节能的 EUV 机器技能的需求将抓续增长,而 LLNL 的 BAT 激光技能无疑为这一主见提供了新的可能性。